高效表面钝化:无需退火的a-SiOx:H/AlOx:H纳米双叠层用于n型晶体硅
随着晶体硅太阳能电池技术从PERC向TOPCon、SHJ及背接触等高效结构演进,表面钝化成为决定器件性能的关键因素。在众多钝化材料中,原子层沉积制备的氢化氧化铝(AlOx:H)因其优异的化学钝化和强场效应钝化能力而备受关注。然而,AlOx:H通常需要经过400–500℃的高温后退火处理才能激活其钝化性能,这一工艺限制使其难以应用于硅异质结等温度敏感型电池结构。采用美能全光谱椭偏仪精确测定a-SiOx:H与AlOx:H亚层纳米级厚度,为研究叠层钝化性能与厚度的关联及结构优化提供了关键数据支撑。
本文提出在n型晶体硅表面构建纳米级氢化非晶氧化硅/氢化氧化铝(a-SiOx:H / AlOx:H)双层钝化叠层。该方案利用a-SiOx:H层提供良好的化学钝化并促进上层AlOx:H中Al-O网络的形成,同时通过AlOx:H层引入高密度负固定电荷实现强场效应钝化。实验结果表明,优化后的双层叠层无需后退火处理即可将有效少数载流子寿命提升至5.1 ms,为高效晶体硅电池提供了一种低温、产业兼容的钝化解决方案。
实验方法
实验采用双面抛光和制绒的n型直拉硅片。抛光片电阻率约5 Ω·cm,厚度约300 μm;制绒片电阻率约2 Ω·cm,厚度约130 μm。首先在210℃下用PECVD在硅片双面对称沉积a-SiOx:H层,反应气体为CO₂、SiH₄和H₂。然后在200℃下用热ALD沉积AlOx:H层,铝源为TMA,氧化剂为H₂O,载气为Ar。作为对比,还制备了仅由单层AlOx:H钝化的样品,并在沉积后进行450℃、30分钟退火。
采用WCT-120测试仪在过剩载流子密度Δn=10¹⁵ cm⁻³条件下测量样品的有效少数载流子寿命。用美能全光谱椭偏仪测定各层厚度。用XPS研究叠层化学状态,用TEM观察样品微观结构。为获得界面缺陷态密度和固定电荷密度,对单面沉积叠层的样品进行高频C-V和G-V测量,制备MIS结构(硅片/钝化层/圆形铝电极)。根据C-V曲线计算Qf,根据C-V和G-V曲线计算Dit。用Quokka2软件模拟背接触电池效率对正面复合电流密度的依赖性。
结果与讨论
AlOx:H厚度的影响
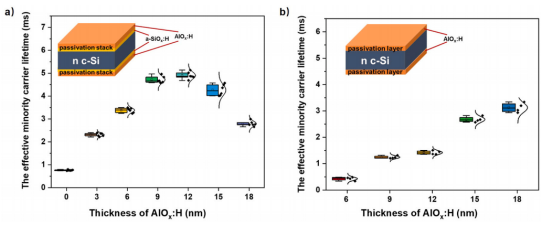
(a) 不同AlOx:H厚度、a-SiOx:H层厚度固定为6 nm的沉积态a-SiOx:H/AlOx:H叠层;(b) 不同厚度、经沉积后退火处理的单层AlOx:H
固定a-SiOx:H层为6 nm,改变AlOx:H厚度。结果显示,单层a-SiOx:H钝化的样品有效少数载流子寿命低于1.0 ms。随着AlOx:H厚度增加,有效少数载流子寿命逐渐上升,在AlOx:H约12 nm时达到最大值约5.1 ms。超过12 nm后,有效少数载流子寿命反而下降。相比之下,经退火的单层AlOx:H在12 nm时有效少数载流子寿命仅约1.5 ms,即使增加到18 nm也仅约3.3 ms。这表明AlOx:H和a-SiOx:H的组合产生了任何单层无法实现的协同效应。
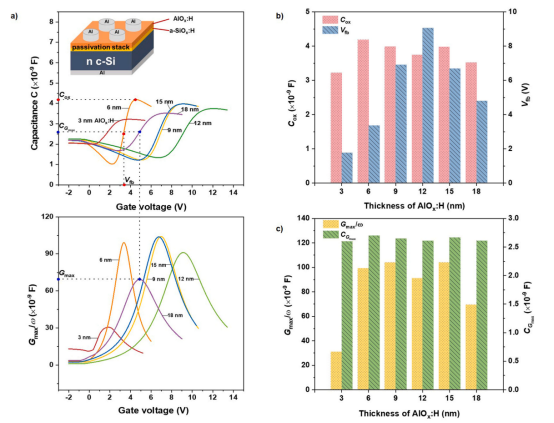
MIS结构样品的测量结果:(a)高频C-V和G-V曲线;(b) Cox和Vfb的值;(c) Gmax/ω和Cmax的值
对MIS结构样品进行C-V和G-V测量。随着AlOx:H厚度增加,平带电压Vfb先向更正方向移动,在12 nm时达到峰值,然后回移。所有Vfb均为正,表明固定电荷为负。
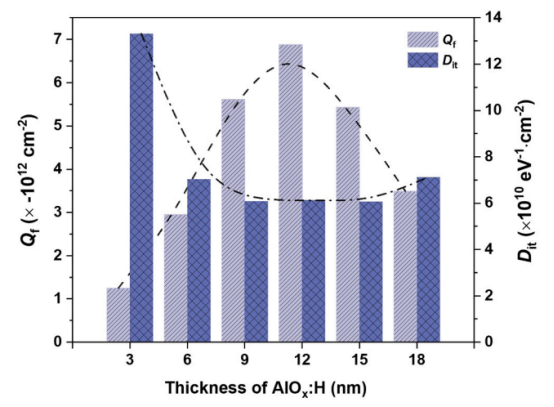
a-SiOx:H/AlOx:H钝化叠层(a-SiOx:H层厚度固定为6 nm,AlOx:H层厚度变化)诱导产生的Qf和Dit的计算值
根据公式计算Qf和Dit。绝对Qf随AlOx:H厚度先增后减,在12 nm时达到最大值约6.88×10¹² cm⁻²。Dit在AlOx:H从3 nm增至6 nm时显著降至10¹⁰ eV⁻¹cm⁻²量级,之后保持稳定。这说明Dit主要受近界面区影响,AlOx:H增厚主要通过提高Qf增强场效应钝化。

XPS谱图:(a) 3 nm,(b) 6 nm,(c) 9 nm,(d) 12 nm,(e) 15 nm
XPS分析显示,AlOx:H较薄时(<6 nm),Al-OH键占主导;厚度增加,Al-O峰增强,Al-OH峰减弱;12 nm时Al-OH峰消失;超过12 nm,Al-OH峰再次出现。绝对Qf的变化趋势与Al-O峰强度一致,说明形成更致密的Al-O网络有利于提高Qf。这些结果表明,近界面区需要较薄(~6 nm)的AlOx:H以确保低Dit,而增加厚度至12 nm可最大化Qf,实现化学钝化和场效应钝化的协同优化。
a-SiOx:H厚度的影响

有效少数载流子寿命等高线图
固定AlOx:H为12 nm,改变a-SiOx:H厚度。等高线图显示,单层a-SiOx:H的有效少数载流子寿命随厚度增加缓慢上升,18 nm时仅略高于1 ms。叠层后,所有a-SiOx:H厚度的样品有效少数载流子寿命均显著提升。a-SiOx:H厚度低于6 nm时提升不明显,达到6 nm及以上时有效少数载流子寿命饱和于约5 ms。考虑到a-SiOx:H的光学吸收,优选厚度为6 nm,可在保证钝化效果的同时最大限度减少寄生吸收。

MIS结构样品的测量结果:(a)高频C-V和G-V曲线;(b) Cox和Vfb的值;(c) Gmax/ω和Cmax的值
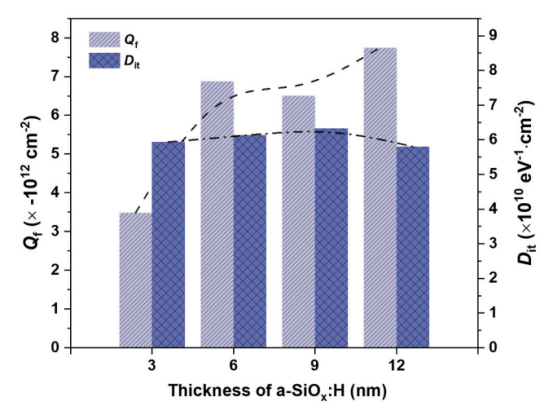
样品的Qf和Dit计算值
C-V和G-V测量表明,a-SiOx:H从3 nm增至6 nm时,绝对Qf从3.5×10¹² cm⁻²几乎翻倍,之后趋于饱和。Dit则基本稳定在约6×10¹⁰ eV⁻¹cm⁻²,对厚度变化不敏感。这说明a-SiOx:H厚度主要影响Qf,而非Dit。

XPS谱图:(a) 3 nm,(b) 6 nm,(c) 9 nm
XPS显示,3 nm a-SiOx:H的叠层同时存在Al-O和Al-OH峰,6 nm及以上时仅存Al-O峰。这与Qf的变化一致,表明足够厚的a-SiOx:H有利于形成更纯净的Al-O网络,增强场效应钝化。
a-SiOx:H层氧含量的影响
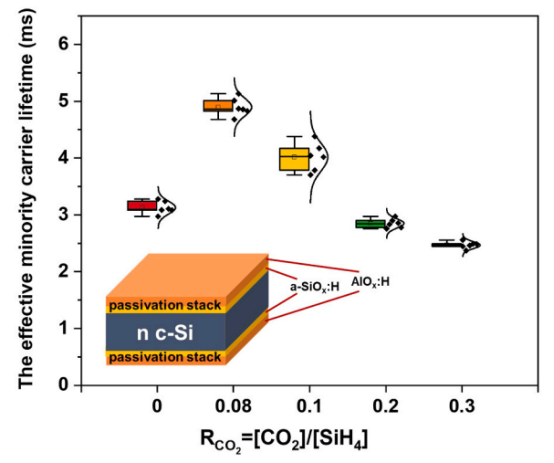
有效少数载流子寿命图
固定a-SiOx:H为6 nm、AlOx:H为12 nm,改变沉积a-SiOx:H时的CO₂/SiH₄流量比RCO₂。结果显示,有效少数载流子寿命对RCO₂高度敏感:从0开始上升,在0.08时达到峰值约5 ms,之后下降。与a-Si:H/AlOx:H叠层相比,RCO₂=0.08和0.10的a-SiOx:H/AlOx:H叠层有效少数载流子寿命显著更高。

MIS结构样品的测量结果:(a)高频C-V和G-V曲线;(b) Cox和Vfb的值;(c) Gmax/ω和Cmax的值
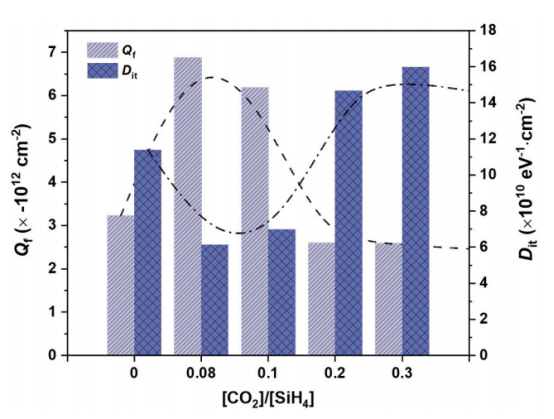
Qf和Dit计算值
C-V和G-V测量显示,RCO₂从0增至0.08时,Vfb向更正方向移动,绝对Qf从约3×10¹² cm⁻²增至约6×10¹² cm⁻²,Dit从1.14×10¹¹ eV⁻¹cm⁻²降至约6×10¹⁰ eV⁻¹cm⁻²。RCO₂超过0.08后,Qf下降,Dit上升。这说明适量氧掺入(RCO₂=0.08)可同时优化Qf和Dit,过量氧则导致a-SiOx:H过氧化,降低钝化质量。
叠层结构表征
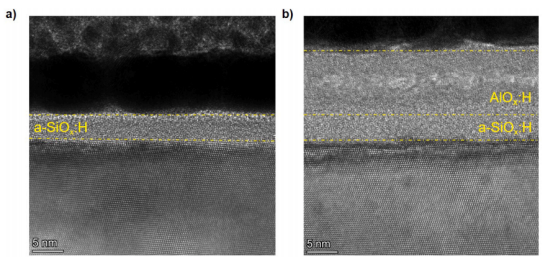
样品的横截面透射电镜图像:(a) a-SiOx:H单层,(b) a-SiOx:H/AlOx:H双层叠层
TEM图像显示,6 nm单层a-SiOx:H与硅衬底界面光滑、厚度均匀。6 nm a-SiOx:H/12 nm AlOx:H双层叠层中,两层均为非晶态,界面清晰、无相互扩散,AlOx:H均匀覆盖a-SiOx:H。这种结构有利于实现稳定的协同钝化:a-SiOx:H提供化学钝化,其合适的氧含量和厚度促进Al-O键形成;AlOx:H则通过高密度负固定电荷提供强场效应钝化。
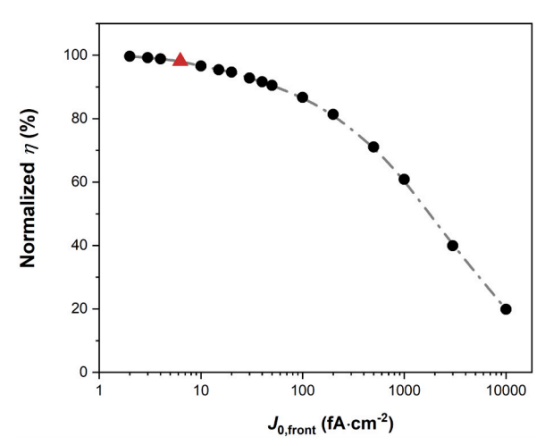
通过Quokka2模拟获得的背接触太阳能电池效率对其正面复合电流密度的依赖性
Quokka2模拟显示,电池效率随正面复合电流密度J0,front增加而单调下降。根据实验获得的5.1 ms有效少数载流子寿命,计算得J0,front约为6.28 fA/cm²,对应的模拟效率仍高于J0,front=0时最大效率的98%,表明该钝化方案在实际器件中具有良好应用前景。
在n型晶体硅片上采用纳米a-SiOx:H/AlOx:H双层叠层,无需后退火即可获得优异钝化性能。AlOx:H最佳厚度为12 nm,可提供高达-6.9×10¹² cm⁻²的负固定电荷密度,使有效少数载流子寿命达5 ms。XPS显示,这得益于Al-OH的抑制和Al-O网络的形成。a-SiOx:H厚度主要影响Qf,对Dit影响有限。沉积a-SiOx:H时,RCO₂=0.08可同时优化Qf和Dit,过量氧则降低钝化质量。优选6 nm a-SiOx:H结合12 nm AlOx:H,可在保证钝化效果的同时减少寄生吸收。TEM证实该叠层结构保形、非晶、界面清晰。该方案为高效晶体硅电池提供了一种简便、无需退火的钝化途径。

联系电话:400-008-6690
全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
n 先进的旋转补偿器测量技术:无测量死角问题。
n 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
n 秒级的全光谱测量速度:全光谱测量典型5-10秒。
n 原子层量级的检测灵敏度:测量精度可达0.05nm。
美能全光谱椭偏仪精确测定a-SiOx:H和AlOx:H亚层的纳米级厚度。凭借其宽光谱范围和优异的测量精度,确保了双层叠层厚度的可控性,为系统研究各亚层厚度对钝化性能的影响提供了可靠的数据支撑。正是基于其准确的厚度标定,本研究得以优选出6 nm a-SiOx:H/12 nm AlOx:H的最佳结构,在不经过后退火的情况下实现了5.1 ms的高效钝化性能。
原文参考:Preparation of nano a-SiOx:H/AlOx:H bilayer stack without post-deposition annealing to obtain efficient surface passivation on n-type crystalline silicon